可实现更小晶体管的下一代技术是高数值孔径EUV光刻
摩尔定律是指在给定面积的硅片上,晶体管的数量大约每两年翻一番,这种增益推动了计算技术的发展。在过去半个世纪里,我们将该定律视为一种类似进化或衰老的不可避免的自然过程。然而,现实却大不相同。要跟上摩尔定律的步伐,需要花费几乎难以想象的时间、精力和人类智慧,地球上无数的人和无数台最复杂的机器都被裹挟其中。
其中最重要的可能就是极紫外(EUV)光刻机了。EUV光刻技术是几十年研发工作的产物,是过去两代尖端芯片背后的驱动技术,过去3年里,每一款高端智能手机、平板电脑、笔记本电脑和服务器中都有它的身影。然而,摩尔定律必须继续前进,芯片制造商也在继续推进他们的路线图,这意味着需要进一步缩小设备的几何尺寸。
因此,我和我的同事们正在阿斯麦公司(ASML)开发下一代光刻技术。该技术名为“高数值孔径EUV光刻术”,涉及了对系统内部光学系统的重大改造。高数值孔径EUV应该能够于2025年投入商用,在这个十年结束前,芯片制造商有望依靠它来持续进步。

摩尔定律的维系有赖于光刻技术分辨率的提高,这样一来,芯片制造商就可以制造越来越精细的电路。在过去的35年里,通过研究光的波长、封装过程相关因素的系数k1以及衡量系统发光的角度范围的数值孔径(NA)这3个因素的组合,工程师们已经将分辨率提高了两个数量级。
临界尺寸是使用某种光刻曝光工具可以打印的最小产品尺寸,它与光的波长除以光学元件的数值孔径所得的值成正比。因此,我们可以通过使用更短的光波长或更大的数值孔径,或者两者的结合来实现更小的临界尺寸。例如,通过改进制造过程控制,k1值可以尽可能地接近其物理下限0.25。
一般来说,提高分辨率最经济的方法是提高数值孔径,以及改进工具和过程控制以实现更小的k1。芯片制造商只有在无法进一步提高数值孔径和k1时,才会想办法缩短光源波长。
不过,这个行业已经多次修改了波长。波长历史的发展从使用汞灯产生的365纳米开始,到20世纪90年代后期通过氪-氟激光器生产的248纳米,再到本世纪初通过氩-氟激光器生产的193纳米。对于每一代波长,在行业采用更短的波长之前,光刻系统的数值孔径都是逐渐增大的。
例如,随着193纳米的使用即将结束,人们又引入了一种新的方法来扩大数值孔径:浸没式光刻。通过在透镜底部和晶圆之间放置水,数值孔径可以从0.93大幅提高到1.35。自2006年左右推出以来,193纳米浸没式光刻技术一直是业界领先的主力光刻技术。

不过,随着对印刷小于30纳米产品的需求增加,以及193纳米光刻技术的数值孔径已经达到极限,要跟上摩尔定律的步伐变得越来越复杂。要制造小于30纳米的产品,要么需要使用多种图案来制造单层芯片产品(这是一种技术成本和经济成本都很高的技术),要么需要改变波长。经过20多年的时间和前所未有的开发研究,13.5纳米EUV这一新波长才得以上线。
EUV需要一种全新的发光方式。这是一个非常复杂的过程,需要用强大的二氧化碳激光撞击在半空中滴落的熔锡液滴。激光会将锡蒸发成等离子体,发射出光子能量光谱。EUV光学元件可从这个光谱中获得所需的13.5纳米波长,并引导它通过一系列镜子,再将其反射到有图案的掩模上,将图案投射到晶圆上。整个过程必须在超净真空中完成,因为13.5纳米波长会被空气吸收。(前几代光刻技术都是引导光穿过掩模,将图案投射到晶圆上。但是EUV非常容易被吸收,因此掩模和其他光学元件必须具有反射性。)
从193纳米光转变为EUV在一定程度上缩小了临界尺寸。一种名为“可制造性设计”的方法大大降低了k1。该方法设置了电路模块的设计规则,利用了光刻技术的局限性。现在是时候再次提高数值孔径,从目前的0.33提高到0.55了。
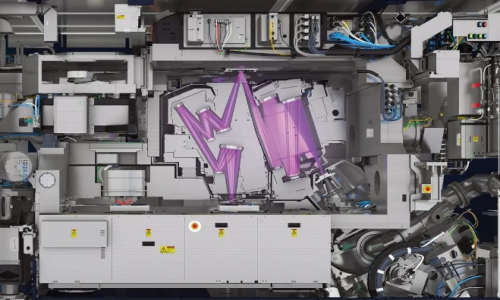
在真空室中,EUV光(紫色)在从光掩模)反射之前,会被多面镜子反射。光从那里继续反射,直到被投射到晶圆上,且携带光掩模的图案。这张插图显示了目前数值孔径为0.33的商业系统。在数值孔径为0.55的未来系统中,光学元件将有所不同。
要将数值孔径从0.33提高到0.55的目标值,不可避免地需要一系列其他调整。EUV光刻等投影系统在晶圆和掩模上都有数值孔径。增大晶圆上的数值孔径时,掩模上的数值孔径也会增大。因此,掩模入射和出射的光锥会变得更大,且必须彼此斜向远离以避免重叠。重叠的光锥会产生不对称的衍射图案,进而带来不理想的成像效果。

在过去的35年里,光刻技术的分辨率提高了大约两个数量级,部分是因为使用的光波长越来越小,但也需要更大的数值孔径和更好的处理技术
但是这个角度是有限制的。因为EUV光刻技术所需要的反射掩模实际上是由多层材料制成的,所以我们无法确保在某个反射角以上产生合适的反射。EUV掩模的最大反射角为11度。虽然还有其他困难,但反射角是最大的挑战。

如果EUV光以太陡的角度照射到光掩模上,将无法恰当反射。
克服这个挑战的唯一方法是增加一种叫做“缩倍”的特征。顾名思义,缩倍是指从掩模中取出反射图案并缩小它。为了弥补反射角的问题,我和同事们不得不将缩倍数提高到8。结果,在晶圆上成像的掩模部分小了很多。成像场较小意味着需要更长的时间来产生完整的芯片图案。事实上,这一要求会使我们的高数值孔径扫描仪的产出率降低到每小时100片晶圆以下,该生产率水平会使芯片制造变得不经济。
令人欣慰的是,我们发现只需要在一个方向上提高缩倍,也就是反射角最大的方向,另一个方向上的缩倍可以保持不变。如此一来,晶圆上就有了一个大小可以接受的成像场——大约是今天EUV系统所用尺寸的一半,即26毫米×16.5毫米,而不是26毫米×33毫米。这种方向相关或失真的缩倍形成了我们高数值孔径系统的基础。光学元件制造商卡尔•蔡司已经付出了巨大努力来设计和制造符合我们新机器规格要求的变形透镜。
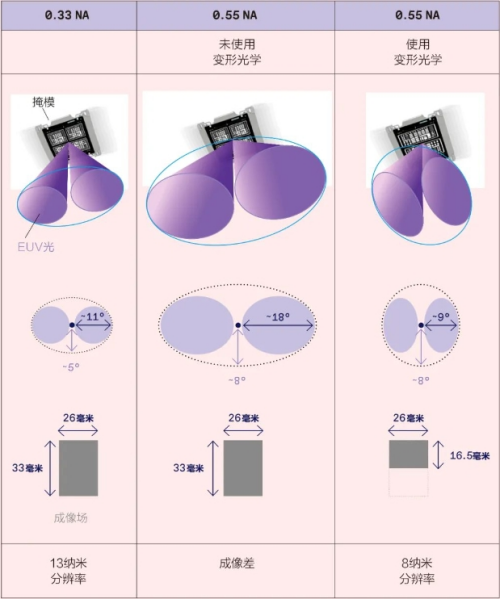
在目前的EUV中,掩模的反射角已经达到了极限(左栏)。提高EUV的数值孔径会导致反射角太宽(中间栏)。所以,高数值孔径EUV使用了变形光学,只允许一个方向的角度增加(右栏)。使用这种方式,成像场只有一半大小,因此掩模上的图案一定会在一个方向上扭曲,但这足以维持机器的产出率。
为了确保半尺寸场具有相同的生产率水平,我们必须重新开发系统的掩模台和晶圆台(分别固定掩模和晶圆的两个平台),并在扫描过程中同步移动它们。经过重新设计,我们拥有了纳米级精度的平台,且加速度提高了4倍。
第一个高数值孔径EUV系统ASML EXE:5000将于2024年初安装在我们与比利时纳米电子研究机构Imec联合开设的新实验室中。该实验室将助力客户、掩模制造商、光刻胶供应商等开发实现高数值孔径EUV所需的基础设施。
我们必须让它成为现实,因为高数值孔径EUV是维系摩尔定律的关键组成部分。不过,实现0.55数值孔径并不是最终目标。阿斯麦、蔡司和整个半导体生态将在此基础上以我们难以想象的方式向更好、更快、更新颖的技术迈进。












 关注微博
关注微博 关注微信
关注微信 关注公众号
关注公众号 关注抖音号
关注抖音号